
Fig. 1. Typical SiC-coated graphite susceptor (pancake type).
탄화규소(SiC)는 강도가 높고, 내식성, 내산화성, 내열충격성 등이 우수하기 때문에 고온반도체, 고온구조재료, 반도체용 부재 등으로의 응용에 유망한 소재이다. 탄화규소는 일반적으로 상압소결에 의해 제조되어지나 소결탄화규소의 경우에 제조시 일반적으로 2000oC 이상의 고온이 필요하고, 소결체 내에 소결첨가제와 기공을 포함하고 있으므로 순도가 떨어진다는 단점울 갖고 있다. 이에 비해 화학증착에 의해 제조된 탄화규소(chemically vapor deposited SiC, CVD-SiC)는 Si 및 C 를 포함하는 기체를 이용하여 소결과정을 거치지 않고 기체로 부터 직접 고체를 형성하므로 1200-1500oC 정도의 낮은 온도에서 소결조제의 첨가 없이 치밀한 SiC를 얻을 수 있다는 장점을 갖고 있다. 따라서 CVD-SiC 는 다방면으로의 응용이 검토되고 있고, 현재 대표적으로 사용되고 있는 곳이 반도체 웨이퍼 처리용 susceptor 이다.
화학증착에 의한 탄화규소 피복흑연 susceptor 는 반도체 제조공정중 silicon epitaxy 공정에 사용되는 웨이퍼 처리용 부재이다. Silicon epitaxy 공정은 Bipolar 와 BiCMOS IC 제조공정에 필수적이며, 여러가지 소자(device) 제조에도 필수적이고, MOS IC 제조공정에서도 중요하게 부각되고 있는 공정이다 [1].
화학증착에 의한 탄화규소 피복흑연을 사용하는 이유는 silicon epitaxy reactor는 유도가열로로서 유도가열을 위하여 흑연이 필요하고, 또한 흑연으로 부터 Si wafer로의 불순물 확산을 막고, Si을 etching 시키는데 사용되는 HCl로 부터 부식에 견디는 재료로서 화학증착 탄화규소 피복층이 필요하기 때문이다. Fig.1 은 대표적인 탄화규소 피복흑연 susceptor의 사진을 보여준다.

Fig. 1. Typical SiC-coated graphite susceptor (pancake type).
흑연기재는 많은 기공 과 유기물 및 천이금속(transition metal)의 불순물을 포함하고 있으므로 반도체 웨이퍼 처리용 치구 등에 응용하기 위해서는 탄화규소 화학증착(chemical vapor deposition, CVD)을 하기전에 이와 같은 불순물들을 제거하는 것이 중요하다. 흑연의 고순도화 공정은 아래와 같다.
- Thermal purification [2]
- 2500oC
- Fluorine 또는 Chlorine radical 사용
- 천이금속의 함량을 10 ppm 이하로 줄일수 있음.
- 전기로에서 CCl2F2 기체 사용 [3]
- 고온에서 halogen화 기체 또는 halogen화 수소기체 사용 [4]
- Ultra-purification [5]
- 일본 Toshiba Ceramics사가 개발
- Total ash content를 5 ppm 이하로 줄일수 있음.
Table 1 은 종래의 방법과 ultra-purification 에 의해 고순도화된 흑연 기재내의 불순 물 함량 비교표를 보여준다.

Table 1. Comparison of impurity content after purification [5]
화학증착에 의한 탄화규소 피복흑연을 제조하기 위해서는 아래와 같은 특성을 갖는 흑연이 필요하다.
위와 같은 특성을 갖는 흑연재질을 Table 2 에 요약하였다.

Table 2. High purity graphite for susceptor
주로 아래의 화학반응에 의해 이루어진다 [6].

화학증착시 균일한 증착속도와 미세구조를 얻기 위해서는 반응관 내에서 기체의 흐름이 laminar flow 가 되어야 하고 recirculating back flow 는 바람직하지 못하다. Recirculating back flow 를 제거하는 방법으로는 (i) high gas flow rate 의 이용 및 (ii) porous glass fiber 와 같은 distributor 의 이용 방법 등이 보고 되어졌다 [7]
CVD-SiC 피복흑연 susceptor 는 silicon epitaxy 공정에 필수적인 소재로서, barrel 형 과 pancake 형 susceptor 가 널리 사용되고 있다. Susceptor 는 고순도 탄화규소 증착층을 가져야 하고, HCl 에 대한 내식성이 강해야 하며, 열충격저항성이 커야한다 [2]. Fig. 2 및 Fig. 3는 화학증착 탄화규소 피복흑연의 절단면과 표면층의 전자현미경 사진을 보여준다.
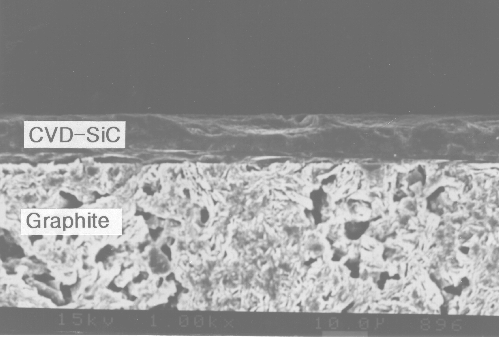
Fig. 2. Typical cross-section of CVD-SiC coated graphite.

Fig. 3. Typical microstructure of CVD-SiC surface layer.
Table 3 는 epitaxy reactor 의 standard size 를 보여주며, Table 4는 대표적인 CVD-SiC 피복증의 특성을 보여준다.

Table 3. Standard size of susceptors [8]

Table 4. Properties of the CVD-SiC coating layer [5, 8-10]
1. M. L. Hammond, "Epitaxial Silicon Reactor Technology - A Review Part 1: Reactor Technology," Solid State Tech., May 159-64(1988).
2. K. Brennfleck et al., "CVD of SiC on an Industrial Scale," Proc. 11th Int. Conf. Chem. Vap. Dep., Seattle, WA, ed. by K.E.Spear and G.W.Cullen, Electrochemical Soc., Pennington, NJ, 1990.
3. Japan Patent 昭 62-145726 (June 29, 1987).
4. Japan Patent 平 3-60117 (March 15, 1991).
5. Brochers, Toshiba Ceramics Co., LTD. Tokyo, Japan.
6. F. Christin & R. Naslain, "A Thermodynamic & Experimental Approach of Silicon Carbide-CVD Application to the CVD Infiltration of Porous Carbon-Carbon Composites," Proc. of the 6th International Conference on CVD, The Electrochemical Society, 1979.
7. J.L. Fitzjohn and W.L. Holstein, "Divergent Flow in Chemical Vapor Deposition Reactors," J.Electrochem.Soc., 137[2] 699-703(1990).
8. Brochers, Midland Materials Research, Inc., Midland, Michigan, U.S.A.
9. CVD Materials, Tech. Bull. #107, Morton International, Woburn, MA, U.S.A.
10. Brochers, Toyo Tanso Co., LTD., Osaka, Japan.
1997년 9월 23일 김영욱